ANZINE : CAE 기술 매거진
이전 ANZINE Home Tech-Insight
▶ 66호 : Ansys Chemkin을 활용한 CVD 반응기 해석
- 염기환 매니저
- 태성에스엔이
- ghyeom@tsne.co.kr
Ansys Chemkin을 활용한 CVD 반응기 해석
Introduction
Ansys Chemkin에서는 가스상에서 발생하는 화학반응뿐만 아니라 증착이나 식각(Etching)과 같은 표면반응도 해석할 수 있는 기능과 모델을 제공한다. Chemkin의 표면반응 해석기능을 사용하면 증착공정에서 운전조건과 표면반응에 대한 상관관계를 이해하고, 다양한 조건에 따른 결과물을 빠르고 정확하게 확인할 수 있다. 이번 호에서는 Chemkin에서 제공하는 CVD(Chemical Vapor Deposition) 반응기의 활용 방법에 대해 알아본다.
Ansys Chemkin에서 표면반응 해석 모델
Chemkin에서는 밀폐형 또는 개방형 반응기와 같은 일반적인 반응기 모델부터 화학공정에 사용되는 관형반응기 모델, 화염 및 연소 특성에 대해 계산하는 연소기 모델, 전자공학에서 사용되는 플라즈마 반응기 모델과 CVD 모델을 제공하고 있다.
[그림 1]에 나타난 반응기 중 일부는 표면반응에 대해 정의할 수 있어 흡착, 탈착, 증착, 식각과 같은 반응을 해석할 수 있다.

[그림 1] 산업군별 Ansys Chemkin 모델 일부
회전을 포함하는 표면반응기 모델로 Rotating Disk Reactor를 통해 Chemkin에서의 반응기 설정 방법과 계산된 결과에 대해 확인하는 방법에 대해서 알아보자.
운전조건 설명 및 전처리 작업(Preprocessing)
이번 예제는 회전하는 단일 웨이퍼 표면에 실리콘이 증착하는 공정에 대해 정상상태 해석을 수행한다. 원료 물질로는 헬륨(He)과 실란(Silane. SiH4) 가스가 유입되며, 두 기체의 분압은 헬륨이 199.89 Torr, 실란이 0.11 Torr이다. 원료물질의 유입유량은 웨이퍼의 회전속도, 내부 압력 및 가스 조성에 의해 자동으로 계산되기 때문에 별도로 입력하지 않는다. 원료의 유입온도는 295K이며, 유입지점은 웨이퍼 표면에서 6.2cm 떨어져 있다. 웨이퍼의 표면온도는 923.15K, 회전속도는 450RPM, 내부 운전 압력은 200Torr이다.
계산을 수행하기에 앞서 Chemkin을 실행하고, 새로운 프로젝트를 생성한 다음 [그림 2]와 같이 Diagram View를 구성하고 Update 버튼을 클릭한다.

[그림 2] Diagram 구성
다음으로 Preprocessing에서 작업경로(Working Directory)와 실리콘 증착 해석에 사용할 Input 파일들을 지정하기 위해 [그림 3]과 같이 설정한다.

[그림 3] 입력파일 설정을 위한 Preprocessing 설정
Input 파일로 Chemistry Set 파일(.cks)이 필요하지만, 해당 파일이 없는 경우 각각의 Input 파일들을 지정해 Chemistry Set 파일을 생성할 수 있다. 각 항목에 입력할 Input 파일의 위치와 파일명은 [표 1]에 나타나 있으며, [그림 3]과 같이 즐겨찾기를 통해서도 해당 경로에 접근할 수 있다.
|
항목명 |
파일명 |
|
파일 경로 |
C:\Users\<계정명> \chemkin\samples<버전명> \rotating_ disk\sih4_cvd |
|
Gas-Phase Kinetics File |
sih4_cvd_chem.inp |
|
Surface Kinetics File |
sih4_cvd_surf.inp |
|
파일 경로 |
\ANSYS Inc\v231\reaction\data |
|
Thermodynamics Data File |
therm.dat |
|
Gas Transport Data File |
tran.dat |
Gas-Phase Kinetics File은 가스상에서 발생하는 반응메커니즘을 포함하고 있는 파일이며, 해당 파일에는 반응식과 아레니우스 방정식의 파라미터 정보가 입력되어 있다. Surface Kinetics File에는 표면반응에 참여하는 물질의 물성정보와 표면 반응에 대한 정보가 입력되어 있다. 그리고 Thermodynamics Data File과 Gas Transport Data File에는 반응에 참여하는 물질의 열역학적 물성과 확산과 관련된 물성을 계산할 수 있는 계수들이 포함되어 있다.
Chemistry Set을 구성하기 위한 파일 지정이 완료되면 Save As… 버튼을 눌러 Chemistry 파일로 저장하고, Run Pre-Processor 버튼을 눌러 계산 준비를 마친다.
Run Pre-Processor가 완료되면 좌측의 Tree에서 하위 항목들이 활성화되고, 다음 작업을 진행할 수 있다. Run Pre-Processor를 실패했을 경우 [그림 4]와 같이 Output 파일을 확인해 문제가 있는 부분을 확인하고 수정 후 Run Pre-Processor를 다시 수행한다.

[그림 4] Preprocessing Output 파일 확인
다음으로 좌측 Tree 메뉴에서 C1_Inlet1을 통해 [그림 5]와 같이 설정한다. Inlet 설정에서 유량은 웨이퍼의 회전속도와 내부 조건에 의해 자동으로 계산되므로 별도로 입력하지 않는다. Inlet 온도는 295.0 K으로 설정하고, 상단의 Species-Specific Properties에서 반응 물질의 조성을 입력한다.
물질의 조성은 Mole Fraction과 Mass Fraction으로 입력할 수 있다. 이번 예제에서는 조성비가 분압에 대한 값으로 제공되었는데, 분압과 Mole Fraction은 같은 비율을 갖으므로 Mole Fraction 입력항에 분압을 입력한다. 분압과 Mole Fraction과의 관계는 이상기체방정식(PV=nRT)로 나타낼 수 있다. 입력된 분압은 [그림 5] 하단의 Normalize 버튼을 눌러 합이 1인 분율값으로 변경할 수 있으며, 별도로 설정을 하지 않아도 Chemkin에서 계산을 수행하면서 자동으로 Normalization이 진행된다.

Inlet 설정을 완료한 뒤에 [그림 6]과 같이 좌측의 Tree 메뉴에서 C1_Rotating Disk를 더블클릭 해 Rotating Disk Reactor 설정을 한다. 먼저 Reactor Physical Properties 탭에서 반응기의 운전조건에 대해 입력한다.

[그림 6] Rotating Disk Reactor 설정 : Reactor Physical Properties 탭
Basic 탭에서는 Solver와 운전조건에 대해 입력한다. 정상상태 해석을 위해 Steady State Solver를 선택하고, 반응에 의한 온도 변화를 확인하기 위해 Solve Gas Energy Equation을 선택한다. 그리고 Inlet을 통해 고정된 조성의 물질이 유입되는 조건으로 Fixed Composition for Inlet Species를 선택한다. 기체의 확산과 관련해서는 열확산을 고려하기 위해 Use Thermal Diffusion(Soret Effect) 옵션을 활성화하고, Use Multicomponent Transport 옵션을 선택한다. 다음으로 질량보존의 수치오류를 보안하기 위한 방법으로 Use Trace Species Approximation을 선택하고, Assign Error to Largest Species를 활성화한다. 위 기능들은 온도차이에 의해 분자량이 다른 화학종간의 확산과 대용량의 운반가스(Carry Gas)가 있는 CVD 반응기와 같은 조건에 적합한 기능이며, 자세한 내용은 Chemkin-Pro Theory Guide에서 확인할 수 있다.
반응 표면(x=0 cm)에서 원료 주입구(x=6.2 cm)까지의 온도는 Profile 기능으로 923K ~ 295K을 입력한다. 그 외에 Pressure는 0.26315789atm(=200 Torr), Surface Temperature는 923.15K, Disk Rotation Rate는 450RPM으로 설정한다.
Inlet의 유량은 자동으로 계산되지만 사용자가 직접 값을 입력해야 되는 경우 Inlet Velocity를 지정할 수 있다. 그 외에 기능들은 이번 예제에서는 필요하지 않은 기능으로 기본 설정을 사용한다.
다음 설정으로 [그림 7]과 같이 Grid Properties 탭으로 이동하여 격자점에 대한 설정과 가스 주입 위치(반응 표면에서의 수직 거리)를 입력한다

[그림 7] Rotating Disk Reactor 설정 : Grid Properties 탭
Number of Uniform Grid Points를 15로 입력하여 초기 격자점을 15개로 설정한다. 초기 격자점은 15개이지만 Adaptive Grid 설정으로 결과값의 변화량에 따라 추가적인 계산 격자점이 생성된다. 빠른 유속이나 반응속도, 급격한 온도차이 등으로 인해 수렴이 되지 않은 경우 격자점을 늘리거나 Solution Gradient와 Solution Curvature에 대한 Adaptive Grid Control 값을 낮춰 수렴된 결과 값을 찾을 수 있다. 그 외 항목에서는 Ending Axial Position을 6.2cm로 입력해 Inlet의 위치를 지정한다.
다음으로 [그림 8]과 같이 Species-specific Properties 탭에서 반응기 내부의 초기 반응 물질의 분율과 중간 생성물질의 최대 몰 비율 등을 설정할 수 있다. 초기값 정의가 잘 될수록 계산의 수렴에 도움이 된다. 하지만 이번 예제에서는 하위 탭에서 Surface Fraction과 Bulk Activity만 설정한다. Surface Fraction 탭에서는 Site 물질의 초기 분율에 대해 설정하며, 물질과 비율은 SIH(S) 0.95, SI(S) 0.05로 입력한다. Bulk Activity 탭에서는 Si(D)를 1로 입력한다. Site 물질은 표면에서 가스와 반응하는 물질을 의미하며, Bulk 물질은 표면반응에 의해 표면에 퇴적(또는 적층)되는 물질로 이해하면 쉽다.

[그림 8] Rotating Disk Reactor 설정 : Species Specific Properties 탭
마지막 항목인 Bulk-Phase-specific Properties 탭에서는 식각(Etching)공정 해석 시 깎여 나가는 물질에 대해 정의하는 부분으로 이번 예제와 무관하므로 설정하지 않는다.
C1_Rotating Disk 설정이 완료된 다음 Solver 설정과 Output Control은 그림 9와 같이 기본값을 사용하고, Continuations로 넘어간다. Solver 설정은 해석의 정확도와 수렴의 안정성과 속도를 조절할 수 있는 부분이며, Output Controls에서는 추가적은 계산 계산결과를 저장하거나, 특정 화학종에 대한 민감도 분석 추가하는 기능을 포함하고 있다.

[그림 9] Solver 및 Output 설정
Chemkin에서 Parameter Study를 진행하는 방법으로 2가지가 있는데 아래와 같다. 그 중 하나가 [그림 10]과 같이 Continuations를 사용하는 방법이다. 좌측의 Tree에서 Continuations을 더블클릭 하면, Set up Continuations 설정창이 나타나는데, 숫자 2를 입력하고 OK를 누른다. 그리고 나타난 설정창에서 Step 1. Select Parameter Group에서 Inlet Stream Properties를 선택하고, Step 3. Select Parameter에서 Reactant Fraction을 선택한다. 그리고 하위에 나타난 Reactant Fraction에서 HE 199.66으로 입력하고 Add Input to Continuation 버튼을 클릭해 항목을 추가한다. 그리고 Reactant Fraction에서 SIH4를 선택하고 0.34를 입력하고 Add Input to Continuation 버튼을 눌러 추가한다.
하단의 Continuation #1에 HE과 SIH4을 입력하고, Continuation #2탭으로 이동하여 다음과 같이 입력한다.
Continuation #2: HE 199.33, SIH4 0.67
위와 같이 Parameter를 설정하여 헬륨과 실란의 비율에 따른 실리콘의 증착 정도 차이를 확인할 수 있다.

[그림 10] Continuations 설정 : Parameter 설정
위 모든 설정이 완료된 뒤에는 [그림 11]과 같이 좌측 Tree 메뉴에서 Run Calculations를 더블클릭하고 나타난 창에서 Begin을 클릭해 계산을 시작한다.

[그림 11] Run Calculations : 계산 수행
계산이 완료되면 [그림 12]와 같이 Analyze Results 창에서 Plot Results by Selecting New Settings를 선택하고 Next Step…으로 넘어간다. 이후 나타난 창에서는 Data Selection 하위의 Solution Sets 탭에서는 모든 항목이 선택되도록 기본 설정으로 두고, Species/Variables 탭으로 이동한다. 본 탭에서는 후처리 작업에서 확인할 변수와 나타낼 몰 분율의 최대, 최소 값을 설정할 수 있다. 실리콘의 몰 분율은 매우 작은 값을 나타내므로 Minimum 값을 1.0E-14으로 설정한다. 하위 Variable은 필요한 변수가 선택되어 있으므로 기본 설정으로 두고 하단의 Process Solution Data를 클릭한다.

[그림 12] Select Post-Processing Variable : 결과항목 선택 창
[그림 13]과 같이 Ansys Chemkin-Pro Visualizer가 실행되면 Line Plot 탭에서 XY그래프 형태로 결과를 확인할 수 있다. 상단의 Plot Set에서는 계산된 Case에 대해서 선택하거나 Case간 결과 비교를 위한 항목을 선택할 수 있다. X Variable에서는 X축에 대한 변수로 Distance나 Parameter Study의 Case 번호나 Input 값들을 선택할 수 있다. Y Variable에서는 압력, 속도, 각 화학종의 분율들을 선택할 수 있으며, Ctrl키나 Shift키를 이용해 여러 개의 결과값을 선택해 출력할 수 있다. 하단의 Plot Style에서는 지수형태 또는 Log형태의 축 값을 선택하고, 사용자 지정의 축을 생성할 수도 있다.

[그림 13] Ansys Chemkin-Pro Visualizer
[그림 14]는 헬륨을 제외한 화학종의 분율을 Log 형태로 거리에 대해 나타낸 결과이다. 원료로 주입된 실란의 몰 분율이 가장 높게 나타났으며, 실리콘의 분율은 1.0E-12 이하로 매우 작은 값을 나타낸다.
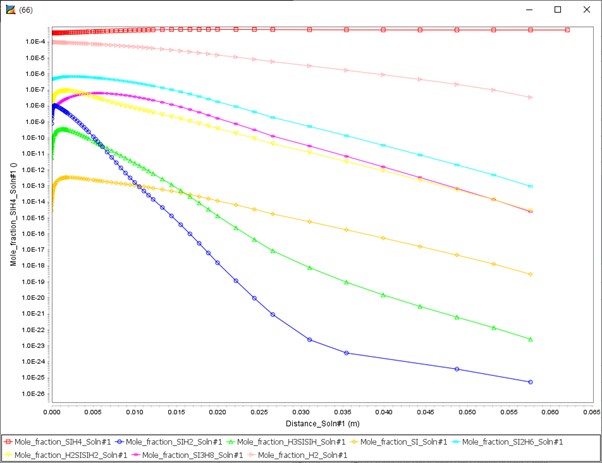
[그림 14] 1번 Case의 거리에 따른 화학종 분율 결과
[그림 15]는 Case 별 실리콘의 증착 속도를 나타낸 결과로, 유입되는 실란의 농도가 높을수록 실리콘의 증착속도가 증가하는 결과가 나타났다.

[그림 15] Case 별 실리콘 증착 속도
맺음말
Ansys Chemkin에서는 다양한 반응기 모델들을 이상적인 조건하에 단순한 형태의 반응기 모델을 제공하고 있다. 이번 호에서는 다양한 반응기 모델 중 반도체 공정에서 사용될 수 있는 Rotating CVD Reactor에 대해서 알아보았다. 단일 반응기 모델로는 복잡한 유동현상을 고려할 수는 없지만, 상세한 화학반응메커니즘을 이용해 빠르고 정확하게 반응현상을 확인할 수 있다. 이러한 장점을 활용하여 다양한 운전조건에 대한 검토 및 예측이 필요한 경우 Ansys Chemkin이 적합한 해결책이라고 생각된다.









 ㈜태성에스엔이
㈜태성에스엔이


